金丝球焊工艺在光模块加工中的应用
发布时间:2023-10-09金丝球焊又称金丝键合,其作为半导体内部引线互连的主流工艺,广泛应用于集成电路中的芯片封装及有源光器件中芯片与外部引脚的互连。
市面上常见的金丝球焊设备的原理是:金丝在设备瞬间高压放电时,尾端形成一个细小的金球(也称FAB,Free Air Ball),利用超声频率的机械振动,使金球与被焊材料表面接触产生塑性形变,在超声辅以温度及压力的条件下,使金属表面原子外层电子相互结合而形成接点。
影响金丝球焊效果常见内部因素主要有四个:超声输出功率、温度、压力以及焊接时间,同时也受一些外部因素的影响,例如金丝的规格、焊点材料、焊点表面洁净度、走线形状等。
光器件加工中常用25um的金丝进行器件内部引脚互连,主要是基于金这种金属良好的延展性(可以拉成足够细的丝线并保证足够的拉力)、导电性、可焊性,以满足通信半导体精细的加工要求及高质量的电信号传输要求。
2. 金丝球焊在光模块生产中的应用
金丝球焊在光模块生产中最常见的两个应用,其一是应用于TO-CAN的加工,另一个则是COB加工工艺。
2.1TO-CAN加工
光器件中的TO-CAN工艺是指将裸芯片(Die)通过环氧胶或金锡焊料等材料固化在TO金属底座(一般底座都采用表面镀金的可伐合金材料)上,通过金丝球焊将内部的引脚及TO上的引脚相互连接形成目标电路,再通过气密封装的方式将DIE及引线保护起来。
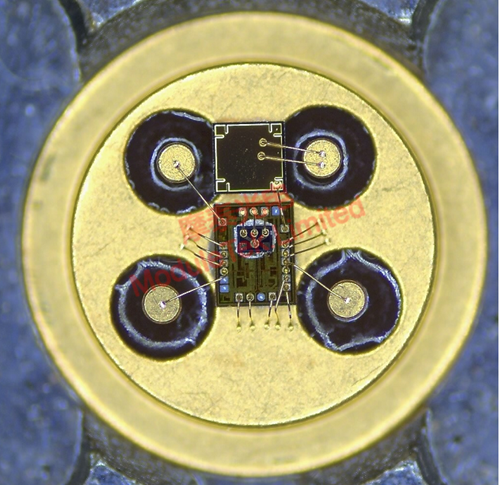
图1 TO-CAN内部金丝球焊示意图
2.2 COB加工
COB(Chip-on-Board)工艺,是指将裸芯片(Die)直接固定在印刷电路板上,然后通过金丝键合,再将芯片和引线进行封装保护的工艺,在信号完整性上具有更好优势,逐步成为高速光模块封装的主流工艺之一。
COB工艺中的金丝球焊的质量除受本身的参数设置因素外,电路板的表面处理工艺也是影响金丝焊接效果的一个重要因素,目前市场上COB电路板推崇的表面工艺是镍钯金工艺。COB工艺详情可查看:光模块COB工艺介绍。
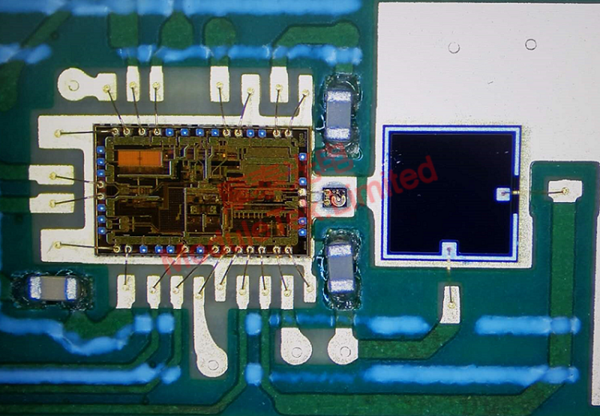
图2 光模块中COB金丝球焊示意图
摩泰光电可提供使用金丝球焊工艺生产加工的光模块产品,欢迎大家选购!

 40G/100G 光模块
40G/100G 光模块 10G/25G 光模块
10G/25G 光模块 155M/622M/2.5G 光模块
155M/622M/2.5G 光模块 100M/1G 光模块
100M/1G 光模块 FC 16G/32G 光模块
FC 16G/32G 光模块 CWDM/DWDM 光模块
CWDM/DWDM 光模块 100M/1G/10G 电口模块
100M/1G/10G 电口模块 有源光缆 AOC
有源光缆 AOC 高速线缆 DAC
高速线缆 DAC 常规/MTP-MPO 光纤跳线
常规/MTP-MPO 光纤跳线 MT2010
MT2010 MT2011
MT2011 CodingBox
CodingBox






